Supports HDI processes such as multi-stage blind vias, laser drilling, and arbitrary layer interconnects.

Prioritize 12–16 layers based on BGA pitch, signal rate, and cost; for 20 layers and above, please confirm your process capabilities with us; the maximum is 32 layers.
HDI 1 n 1
2-16 LayersHDI 2 n 2
6-16 LayersHDI 3 n 3
8-20 LayersHDI 4 n 4
10-20 LayersHDI 5 n 5
12-22 LayersHDI 6 n 6
14-24 Layers




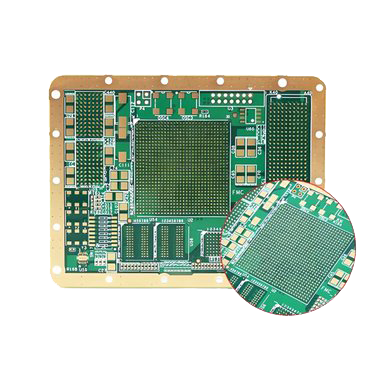
Another Simple and easy way to show your content with less gap. Grab user attention in a more productive way.
Our manufacturing facility is equipped with state-of-the-art CO2 laser drilling and high-precision imaging technology to support the most demanding HDI designs. From rapid prototyping to high-volume mass production, we deliver superior signal integrity and thermal reliability.
Technical Specifications | Mass Production | Prototyping & R&D |
| Layer Count | 4 – 16 Layers | 4 – 24 Layers |
| Board Thickness Range | 0.6mm – 3.2mm (24 – 126 mil) | 0.4mm – 6.0mm (16 – 236 mil) |
| HDI Build-up / Structure | Up to 4+N+4 | Any Layer Interconnect (ELIC) |
| Min. Laser Microvia Size | 4 mil (0.10mm) | 3 mil (0.075mm) |
| Laser Technology | High-Speed CO2 Laser | High-Speed CO2 Laser |
| Material Tg Rating | High-Tg ≥ 170°C | High-Tg ≥ 170°C |
| Copper Plating (Hole Wall) | 12 – 18µm (0.47 – 0.70 mil) | 12 – 18µm (0.47 – 0.70 mil) |
| Impedance Tolerance | ±10% | ±7% |
| Layer-to-Layer Registration | ±3 mil (±0.075mm) | ±2 mil (±0.05mm) |
| Solder Mask Alignment | ±2 mil (±0.05mm) | ±1 mil (±0.025mm) |
| Min. Trace Width / Spacing | 2.5 / 2.5 mil | 2.5 / 2.5 mil |
| Min. Annular Ring | 2.5 mil | 2.5 mil |
| Min. Through-Hole Diameter | 8 mil (0.20mm) | 6 mil (0.15mm) |
| Min. Blind Via Diameter | 4.0 mil (0.10mm) | 3.0 mil (0.075mm) |
| Min. Dielectric Thickness | 3.0 mil | 2.0 mil |
| Min. Solder Pad Size | 12 mil | 10 mil |
| Blind Via Aspect Ratio | 1:1 | 1.2:1 |
Precision Microvias, Any-Layer Interconnects, & Quick-Turn Solutions,Delivering high-performance HDI fabrication with IPC Class 3 reliability, 3-mil trace/space precision, and rapid 6-day prototyping for 5G, automotive, and AI electronics.
Our state-of-the-art laser drilling systems are engineered for high-speed microvia fabrication in HDI designs. Utilizing non-contact, high-precision CO2 and UV laser technology, we achieve ultra-fine blind via processing, ensuring seamless layer-to-layer interconnects in the most complex high-density circuit structures.
Designed for advanced via-in-pad applications, our vacuum resin plugging equipment ensures bubble-free, void-less hole filling. This process is critical for buried vias and high-layer-count boards, enhancing both electrical reliability and the structural integrity of the PCB surface for subsequent plating and assembly.
Our pulse electroplating lines deliver superior copper distribution for blind and buried vias. By utilizing advanced pulse-current technology, we achieve uniform plating thickness and high-reliability copper filling, which is essential for signal integrity and maintaining a perfectly planar surface for high-density components.
The multilayer hot press system utilizes controlled high-temperature and high-pressure cycles to bond internal layers with prepreg (PP). This critical lamination process ensures precise resin flow and curing, resulting in high-strength interlayer bonding and excellent dimensional stability for advanced HDI stackups.
To ensure zero-defect manufacturing, our in-line AOI systems use high-speed cameras and AI-driven image recognition to detect shorts, opens, and pad misalignments. By identifying defects in real-time during the production flow, we maximize yield rates and guarantee IPC Class 3 compliance.
For high-speed and high-current applications, our 4-wire testing machines provide precise low-resistance measurements. By eliminating lead-wire interference through the Kelvin method, we verify the electrical performance and continuity of ultra-fine traces, ensuring long-term reliability in mission-critical environments.